渗透(RO)膜 ——耐药性提高至2倍,更换频率及二氧化碳排放量减半
3月21日,东丽公司官网宣布成功开发出针对工厂废水的再利用及污水处理等严苛的使用条件下、不仅能保持现有的高度污垢去除性,并能长期稳定地生产优质水的高耐久性反渗透(reverse osmosis membrane,RO)膜。RO膜是指把半透膜置于浓的水溶液与稀的水溶液之间并使两者相互接触,因两者的浓度差异而产生的渗透压,会使水从稀的水溶液一侧向浓的水溶液一侧移动。此时如果将大于渗透压的压力施加到浓的水溶液一侧,水就会透过半透膜向稀的水溶液一侧移动。利用这一现象的膜分离法,被称为反渗透法,而反渗透法中所使用的膜则被称为反渗透(RO)膜。RO膜的去除对象是钠、钙等金属离子、氯离子、硫酸离子等阴离子,或农药等低分子有机化合物。
本研发品使膜在清洗时对药物的耐久性提高到过去的2倍,抑制了因膜的老化所引起的性能降低,不但更便于运作管理,还有望实现更换频率减半及碳足迹的改善。现在,东丽正在进行批量生产的准备,计划在2024年上半年,以在市场迅速扩大的中国开始销售为目标,并将其活用于包括日本在内的其他国家与地区的产品开发中。
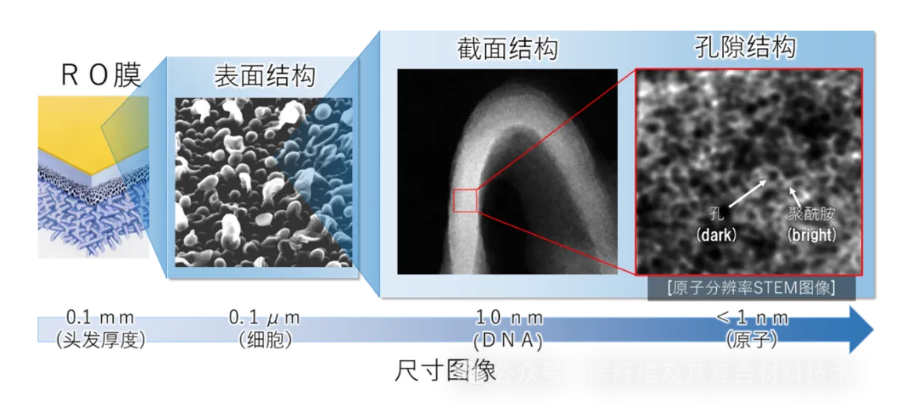
RO膜的结构解析
RO膜作为确保持续性水源的技术,目前广泛用于海水及河水等的淡水化、废水再利用、饮用水生产等。在废水再利用领域,RO膜用于处理各种水质的水,但为了确保其处理性能,必须提高用于膜的除污清洗药物使用频度,这会导致膜孔变形以及除污性能降低。为了解决这些课题,就需要进一步提高RO膜的耐久性。
此次东丽通过将株式会社东丽分析中心所拥有的能直接观察原子排列的尖端结构解析技术(扫描透射电子显微镜:STEM※2)与DX(数字化转型)的数据解析技术两者的融合,对构成RO膜的分离功能层的交联芳香族聚酰胺的小于1纳米(10亿分之一米)的微小孔结构进行了定量解析。根据这一解析,发现了有助于孔结构在接触清洗药物时保持稳定性的部分结构,通过对生产工序的革新性改善,对聚合物结构的重新设计,成功开发出了具有稳定性孔结构的RO膜。
东丽利用这次开发的RO膜,在模拟苛刻的药物清洗条件下的废水再利用工厂进行了运转测试,证实了对于使用新开发的RO膜过滤后的水具有50%的水质恶化抑制效果。在需要高频率药物清洗的污水处理厂、化工厂、钢铁厂及染色工厂等的废水再利用以及消灭废水排放的ZLD(废水零液体排放)※3等的使用中,此技术有望延长RO膜的寿命,并使伴随膜的更换或废弃而产生的二氧化碳排出量降低一半。
今后,东丽将努力完善量产体制,以提供满足客户需求的产品。东丽将在“我们通过创造新的价值,为社会作贡献”这一企业理念下,以有机合成化学、高分子化学、生物技术、纳米技术作为核心技术,开发尖端材料与创新技术,从而为社会的发展做出贡献。
东丽公司成功开发出适用于混合焊接的新型绝缘树脂材料 -为提高半导体高密度集成领域的成品率及可靠性作贡献
3月15日,日本东丽公司官网宣布,已经开发出一种基于聚酰亚胺涂层剂(Semicofine™和Photoneece™)的兼容混合粘合(微粘合)的新型绝缘树脂材料。关于该信息,本号曾在3月16日撰写的文章《日本东丽开发出一种可与混合粘合兼容的新型绝缘树脂材料》中进行了介绍,此次主要结合日本东丽公司中文官网对该产品的特性进行介绍,而且本文中图片也是中文形式进行了处理。
东丽公司此前以在半导体及显示屏的绝缘树脂材料领域拓展事业的聚酰亚胺涂层材料(Semicofine™及hotoneece™)为基础,成功开发出适用于混合焊接(精密焊接)的新型绝缘树脂材料。本材料将以往的聚酰亚胺涂层材料与东丽拥有的加工及焊接技术相融合,有望提高在形成了金属电极的半导体芯片之间相焊接的混合焊接工序中的成品率、及半导体置的可靠性。今后将推进试制品的生产并向客户提供样品,努力在2025年获得材料认证,并在2028年投入量产。
作为近年来常用的高性能封装技术的代表性方法之一,是将半导体芯片进行纵向叠加的3D集成(图1)。尤其是要求凸块间距(用焊锡焊接的相邻电极的间隔)必须在10μm以下的超微结构的高性能半导体芯片,这种混合焊接技术的应用将备受期待。东丽目前已在销售20μm左右微细凸块间距3D集成芯片的凸块间树脂焊接材料,但是与传统的3D集成技术不同,混合焊接不使用凸块,而是金属配线相互之间直接焊接,从而可以进一步缩小配线间距。
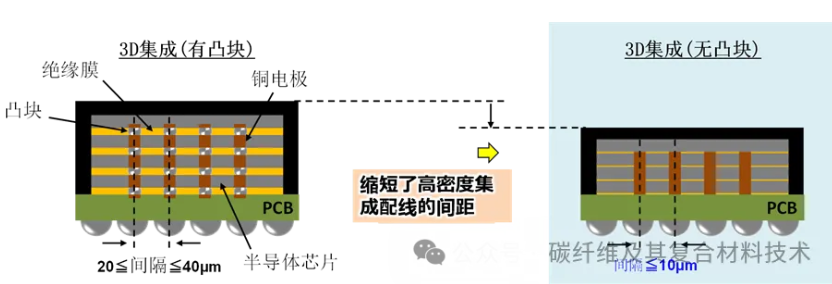
<图1>3D集成封装横截面模式图与有无凸块的封装密度的差别
混合焊接为了将异种芯片进行高密度集成,将一个晶圆基板加工成芯片大小后,与另一个晶圆基板贴合的C2W(Chip to Wafer)集成方式备受瞩目,二氧化硅(SiO2)等无机材料作为绝缘材料被应用于其中。但是采用C2W方式目前存在两大课题。第一是在加工芯片之际容易将切割工序中产生的矽尘在混合焊接时夹杂混入,从而引起芯片的焊接不良,导致成品率下降。第二是混入的矽尘可能有损于半导体封装的可靠性(图2)。
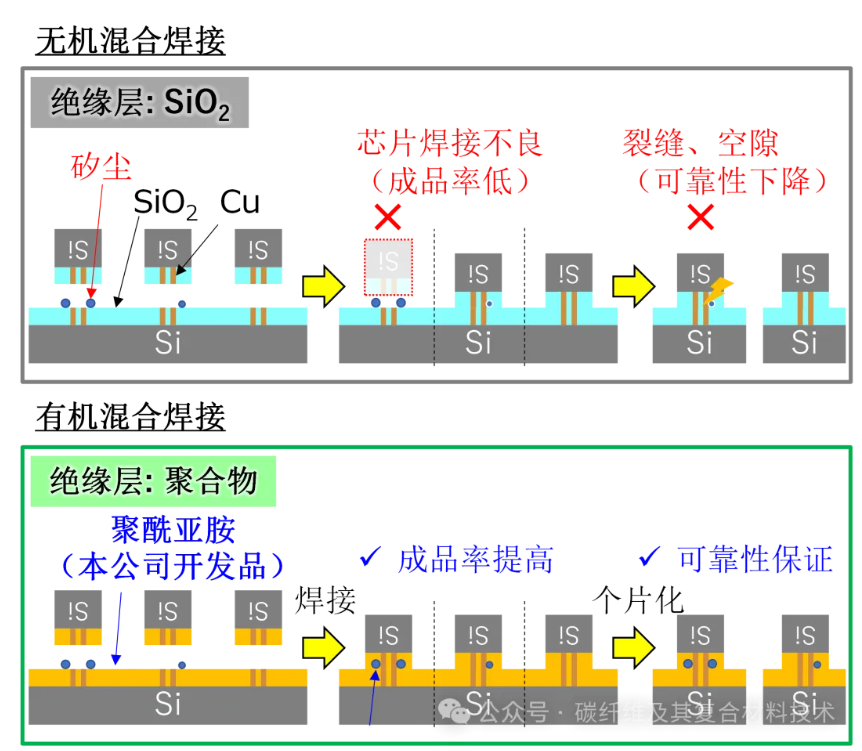
东丽发挥长年积累的功能性塑料的设计技术,从2020年起便与新加坡科学技术研究厅中的半导体研究机构IME(Institute of Microelectronics)协作,通过精准的分子设计和对极限的追求,使用具高耐热性和高机械性能的绝缘树脂材料(聚合物),推进着混合焊接的实证实验(图3)。东丽与IME等半导体关联各公司的协作,旨在通过将本材料应用于C2W方式的混合焊接,提高将异种芯片集成于一个封装中的芯粒的成品率及可靠性。
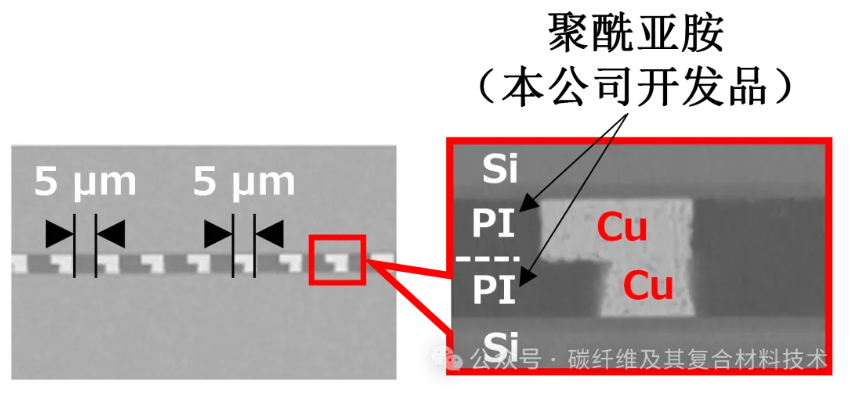
本次开发的材料,在东丽适用于半导体装置及电子零部件的各种树脂产品中又增添了新的产品群,有望活用于高速通信设备及服务器用途,力图为高性能新一代半导体封装所采用。







